
近日,比利时微电子征询中心(imec)在荷兰 Eindhoven 与ASML配合成立的高数值孔径极紫外光(High-NA EUV)光刻执行室中,利用径 0.55NA EUV光刻机(TWINSCAN EXE:5000),发布了曝光后的图形化元件结构。
imec暗意,在单次曝光后,9nm和5nm(间距19nm)的随即逻辑结构、中心间距为30nm的随即通孔、间距为22nm的二维特征,以及间距为32nm的动态随即存取挂牵体(DRAM)专用布局一起告捷成形,秉承的是由imec与其先进图形化征询筹划伙伴所优化的材料和基线制程。通过这些征询恶果,imec阐发该光刻技巧的生态系统如故准备就绪,大致竣事高分离率的 High NA EUV 单次曝光。
由ASML与imec共同成立于荷兰Eindhoven的High NA EUV光刻执行室在近期启用后,客户当今不错使用High NA EUV光刻机来开发非公开的High NA EUV应用案例,这些案例也能利用客户各自的假想规则和布局。
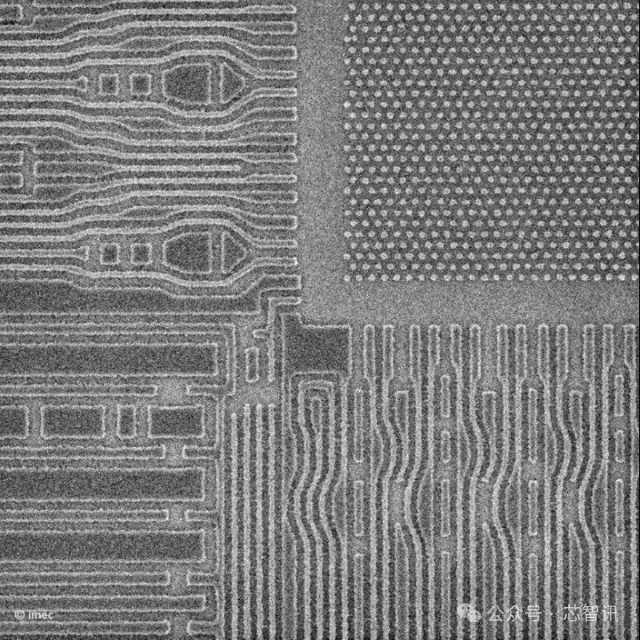
imec告捷利用单次曝光,酿成远离为9nm与半线宽为5nm的随即逻辑结构,异常于间距为19nm,图形尖端(tip-to-tip)的间距达到20纳米以下。中心间距为30nm的随即通孔充分展示了绝佳的图形保真度与重要尺寸均匀度。此外,间距为22nm的2D特征也展现了卓绝的性能,凸显了利用High NA EUV技巧来竣事2D布线的发展后劲。
除了逻辑结构,imec 也告捷利用单次曝光,欧洲性爱为动态随即存取内存(DRAM)制出把电荷储存节点通顺垫(storage node landing pad)与周边位线互相整合的元件图形。这项竖立彰显了High NA EUV技巧的潜能,有望通过单次曝光来取代多层光罩的曝光需求。
赢得这些冲破性恶果后,imec联袂ASML与其伙伴综合配合,启动紧锣密饱读地进行准备使命,为第一代High NA EUV微影技巧来筹备图形化生态系统与量测技巧。在进行屡次曝光之前,imec准备了专用的晶圆堆叠(包含先进光阻、涂布底层及光罩),并把像是光学阁下检阅(OPC)、整合图形化及蚀刻技巧等high NA EUV基线制程整合到0.55NA EUV光刻机台上。
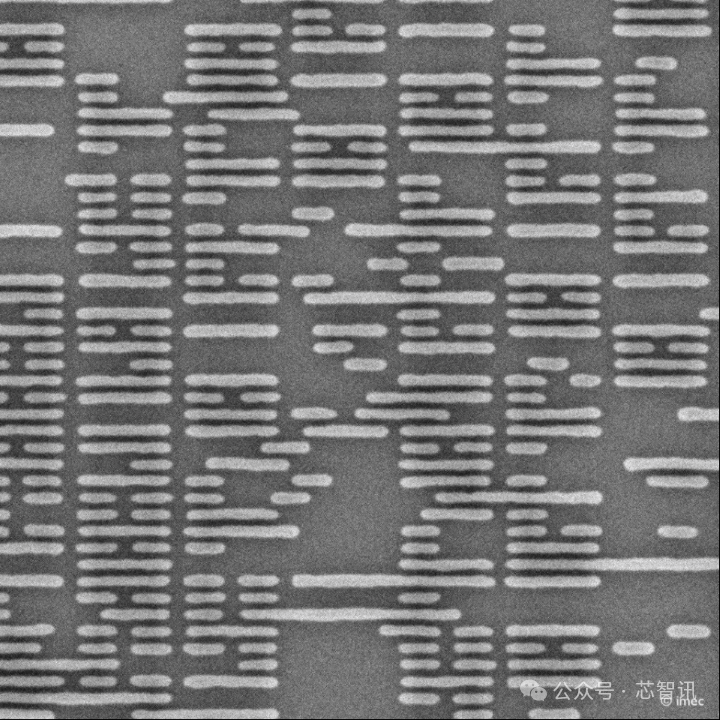
imec 规划技巧与系统/规划系统延迟高等副总裁Steven Scheer暗意:“咱们很欢喜在 ASML-imec 聚首执行室中展示了天下上第一个支执HighNA EUV的逻辑和内存图案化,这是对行业应用的初步考证。为止展示了HighNA EUV 的私有后劲,不错竣事大领域 2D 特征的单次打印成像,提升假想纯真性并镌汰图案化资本和复杂性。瞻望改日,咱们但愿为咱们的图案化生态系统配合资伴提供真贵的见地,支执他们进一步完善High NA EUV 特定材料和征战。”
imec 总裁兼首席扩充官Luc Van den hove 暗意:“为止阐发了HighNA EUV 光刻技巧永久以来预测的分离率身手,一次曝光即可竣事 20nm 以下间距的金属层。因此,HighNA EUV 将对链接竣事逻辑和内存技巧的尺寸缩放发达贫苦作用,这是将阶梯图推向‘埃时期’的重要相沿之一。这些早期演示之是以大致竣事,要归功于 ASML-imec 聚首执行室的成立,这使咱们的配合资伴大致加快将HighNA EUV光刻技巧引入制造业。”
裁剪:芯智讯-林子 开端:imec【DBEB-054】超手強い女をコテンパンにイカせまくる!危険な香りの絶頂BEST ~その時オンナは涙のように汁を垂れ流す~
 海量资讯、精确解读,尽在新浪财经APP
海量资讯、精确解读,尽在新浪财经APP
